MOS管的高頻小信號電容
從MOS管的幾何構造及工作原理能夠發現,MOS管存在著多種電容,這會影響MOS管的高頻性能。
依據MOS管的幾何構造構成的各類電容如圖1.5所示,詳細為:
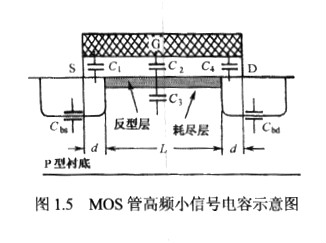
(1)柵與溝道之間的柵氧電容C2=WLCox,其中Cox為單位面積柵氧電容ε0x/tox。
(2)溝道耗盡層電容C3=W):其 中q為電子電荷,εsi硅的介電常數,Nsub為襯底濃度,φF為費米能級。
中q為電子電荷,εsi硅的介電常數,Nsub為襯底濃度,φF為費米能級。
(3)交疊電容(多晶柵掩蓋源/漏區所構成的電容),每單位寬度的交堯電容記為Col,由于是環狀的電場線,Col不能簡單計算得到,且它的值與襯底偏置有關。交疊電容主要有柵/源交疊電容Cl= WCol與柵/漏交疊電容C4= WCol。
(4)源/漏區與襯底間的結電容:Cbd, Cbs,即為漏極、源極與襯底之間構成的PN結勢壘電容,這種電容普通由兩局部組成:一局部是垂直方向(即源/漏區的底部與襯底間)的底層電容,以單位面積PN結電容Cj權衡;另—局部是源/漏區的周圍與襯底間構成的橫向圓周電容,以單位長度結電容Cjs來衡最。單位面積PN結的勢壘電容Cj可表示為:
Cj=Cjo/[1+VR/φB]m
式(1.1)中Cjo為PN在零偏電壓時單位底面積結電容(與襯底濃度有關),VR是加于PN結的反偏電壓,φB是漏/源區與襯底問的PN結接觸勢壘差(普通取0.8V),而m是底面電容的梯度因子,普通取介于0.3~0.4間的值。
因而,MOS管源/漏區與襯底間總的結電容可表示為:
CBD.BS=WHCj+2(W+H)Cjs
式(1.2)中H是指源、漏區的長度,W是MOS管的寬度。
由式(1.2)可發現:不同MOS管的源/漏區的幾何外形,即不同的源/漏區面積和圓周尺寸值,存在著不同的結電容。在總的寬長比相同的狀況下,采用并聯合構,即MOS管的H不變,而每一個MOS管的寬為原來的幾分之一,則MOS管的源/漏區與襯底間總的結電容比原構造小。
例1.2 分別求出以下三種條件下MOS管源/漏區與襯底間總的結電容(假定任何,個MOS管的源/漏區的長度都為H):
①(W/L)=100的一個MOS管;
②(W/L)1,2=50兩個MOS管并聯;
③(WIL)1~5=20的5個MOS管并聯。
解:為了計算便當,假定一切MOS管的溝道長度L=0.5μm,H=lμm則有
①CBD,BS:WHCj+2(W+H)Cjs=200Cj+402Cjs
所以總的源/漏區與襯底問的結電容為Cbd+Cbs=400Cj+804Cjs
②Cbdl, 2=Cbs1=Cbs2=100Cj+202Cjs
所以總的源/漏區與襯底間的結電容為Cbd1十Cbs1+Cbd2=300Cj+606Cjs
③Cbd1,2=Cbd3,4=Cbd5=Cbs1=Cbs2,3=Cbs4, 5=40Cj+82Cjs
所以總的源/漏區與襯底間的結電容為
Cbdl,2+Cbd3, 4+Cbsl+Cbs2, 3+Cbs4,5+Cbd5=240Cj+492Cjs
2.MOS管的極間電容及其隨柵/源電壓的變化關系
由于在模仿集成電路中,MOS管普通以四端器件出現,因而在實踐電路設計中主要思索MOS管每兩個端口之間存在的電容,如圖1.6所示,源/漏兩極之間的電容很小可疏忽不計,這些電容的值就是由前面剖析的各種電容組合而成,由丁在不同的工作區時MOS管的反型層厚度、耗盡層厚度等不同,則相應的電容也不相同,所以關于MOS管的極問電容能夠分為三個工作辨別別停止討論。
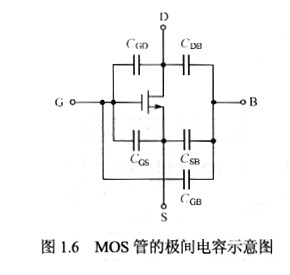
(1)截止區
漏/源之間沒有構成溝道,此時固然不存在反型層,但可能產生了耗盡層,則有柵/源之間、柵/漏之間的電容為:CGD=CGS= WCol;
柵極與襯底間的電容為:CGB=(WLCox)Cd/(WLCox+Cd),即柵氧電容與耗盡層電容Cd的串聯,其中乙為溝道的有效長度,且
CSB與CDB的值分別是源極、漏極與襯底間電壓的函數,能夠由式(1.2)求解出。
(2)飽和區
在此工作區,MOS管的溝道在漏端曾經發作夾斷,所以柵/漏電容CGD大約為WCol;同時MOS管的有效溝道長度縮短,柵與溝道間的電位差從源區的VGS降落到夾斷點的VGS-Vth導致了在柵氧下的溝道內的垂直電場的不分歧,能夠證明此時MOS管的柵+源間電容除了過覆蓋電容之外的電容值可表示為(2/3)N1Cox。因而
CGS=2WLCox/3+WCol (1.3)
(3)深線性區
在此工作區,漏極D與源極s的電位簡直相同,柵電壓變化AV時,惹起等量的電荷從 源極流向漏極,所以柵氧電容(柵與溝道間的電容)WLCox、F均分為柵/源端之間與柵/漏端之間的電容,此時柵/源電容與柵/漏電容可表示為
CGD=CGS=WLCox/2+WCol
當工作在線性區與飽和區時,柵與襯底間的電容常被疏忽,這是由于反型層在柵與襯底間起著屏蔽作用,也就是說假如柵壓發作了改動,導電電荷的提供主要由源極提供而流向漏極,而不是由襯底提供導電荷。
CGD與CGS在不同工作區域的值如圖1.7所示,留意在不同的區域之間的轉變不能簡單計算得到,只是依據趨向停止延伸而得。
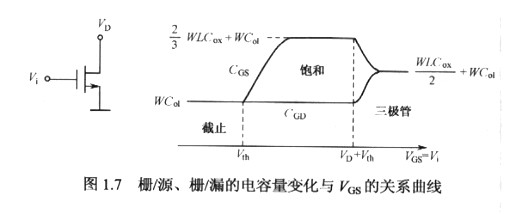
聯系方式:鄒先生
聯系電話:0755-83888366-8022
手機:18123972950
QQ:2880195519
聯系地址:深圳市福田區車公廟天安數碼城天吉大廈CD座5C1
關注KIA半導體工程專輯請搜微信號:“KIA半導體”或點擊本文下方圖片掃一掃進入官方微信“關注”

長按二維碼識別關注