mos管寄生電容
寄生電容
寄生電容一般是指電感,電阻,芯片引腳等在高頻情況下表現出來的電容特性。實際上,一個電阻等效于一個電容,一個電感,和一個電阻的串聯,在低頻情況下表現不是很明顯,而在高頻情況下,等效值會增大,不能忽略。在計算中我們要考慮進去。ESL就是等效電感,ESR就是等效電阻。不管是電阻,電容,電感,還是二極管,三極管,MOS管,還有IC,在高頻的情況下我們都要考慮到它們的等效電容值,電感值。
mos管寄生電容問題
mos管寄生電容是動態參數,直接影響到其開關性能,MOSFET的柵極電荷也是基于電容的特性,下面將從結構上介紹這些寄生電容,然后理解這些參數在功率MOSFET數據表中的定義,以及它們的定義條件。
(一)mos管寄生電容數據表
溝槽型功率MOSFET的寄生電容的結構如圖1所示,可以看到,其具有三個內在的寄生電容:G和S的電容CGS;G和D的電容:CGD,也稱為反向傳輸電容、米勒電容,Crss;D和S的電容CDS。

功率MOSFET的寄生電容參數在數據表中的定義,它們和表上面實際的寄生參數并不完全相同,相應的關系是:
輸入電容:Ciss=CGS+CGD
輸出電容:Coss=CDS+CGD
反向傳輸電容:Crss=CGD
(二)mos管寄生電容測試
mos管寄生電容的測試的條件為:VGS=0,VDS=BVDSS/2,f=1MHz,就是使用的測量電壓為額定電壓的一半,測試的電路所下圖所示。

(a) Ciss測試電路

(d) 標準的LCR
圖2:寄生電容測試電路
mos管柵極的多晶硅和源極通道區域的電容決定了這些參數,其不具有偏向的敏感度,也非常容易重現。
溝槽型功率MOSFET的寄生電容和以下的因素相關:
1、溝道的寬度和溝槽的寬度
2、 G極氧化層的厚度和一致性
3、溝槽的深度和形狀
4、S極體-EPI層的摻雜輪廓
5、體二極管PN結的面積和摻雜輪廓
高壓平面功率MOSFET的Crss由以下因素決定:
1、設計參數,如多晶硅的寬度,晶胞斜度
2、柵極氧化層厚度和一致性
3、體水平擴散,決定了JFET區域的寬度
4、體-EPI和JFET區域的摻雜輪廓
5、柵極多晶硅摻雜通常不是一個因素,由于其是退化的摻雜;JEFET區域的寬度,JFET輪廓和EPI層摻雜輪廓主導著這個參數
高壓平面功率MOSFET的Coss由以下因素決定:
1、所有影響Crss參數,由于它是Coss一部分
2、體二極管PN結區域和摻雜輪廓
(三)mos管寄生電容的非線性
MOSFET的電容是非線性的,是直流偏置電壓的函數,圖3示出了寄生電容隨VDS電壓增加而變化。所有的MOSFET的寄生電容來源于不依賴于偏置的氧化物電容和依賴于偏置的硅耗盡層電容的組合。由于器件里的耗盡層受到了電壓影響,電容CGS和CGD隨著所加電壓的變化而變化。

圖3:AON6512電容隨電壓變化
電容隨著VDS電壓的增加而減小,尤其是輸出電容和反向傳輸電容。當電壓增加時,和VDS相關電容的減小來源于耗盡層電容減小,耗盡層區域擴大。然而相對于CGD,CGS受電壓的影響非常小,CGD受電壓影響程度是CGS的100倍以上。
圖4顯示出了在VDS電壓值較低時,當VGS電壓增加大于閾值電壓后,MOSFET輸入電容會隨著VGS增加而增加。
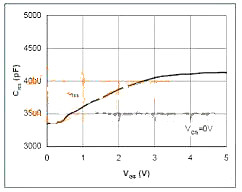
圖4:輸入電容隨VGS變化
因為MOSFET溝道的電子反形層形成,在溝漕底部形成電子聚集層,這也是為什么一旦電壓超過QGD階級,柵極電荷特性曲線的斜率增加的原因。所有的電容參數不受溫度的影響,溫度變化時,它們的值不會發生變化。
mos管器件作電容知識詳解
由于MOS管中存在著明顯的電容結構,因此可以用MOS器件制作成一個電容使用。如果一個NMOS管的源、漏、襯底都接地而柵電壓接正電壓,當VG上升并達到Vth時在多晶硅下的襯底表面將開始出現一反型層。在這種條件下NMOS可看成一個二端器件,并且不同的
柵壓會產生厚度不一樣的反型層,從而有不同的電容值。
(1)耗盡型區:柵壓為一很負的值,柵上的負電壓就會把襯底中的空穴吸引到氧化層表面,即構成了積累區,此時,由于只有積累區出現,而無反型層,且積累層的厚度很厚,因此積累層的電容可以忽略。故此時的NMOS管可以看成一個單位面積電容為Cox的電容,其中
間介質則為柵氧。當VGS上升時,襯底表面的空穴濃度下降,積累層厚度減小,則積累層電容;增大,該電容與柵氧電容相串聯后使總電容減小,直至VGs趨于0,積累層消失,當VGS略大于o時,在柵氧下產生了耗盡層,總電容最小。
(2)弱反型區:VGS繼續上升,則在柵氧下面就產生耗盡層,并開始出現反型層,該器件進入了弱反型區,在這種模式下,其電容由Cox與Cb串聯而成,并隨VGS的增人,其電容量逐步增大。
(3)強反型區:當VGS超過Vth,其二氧化硅表面則保持為一溝道,且其單位電容又為Cox,圖1.29顯示了這些工作狀態。
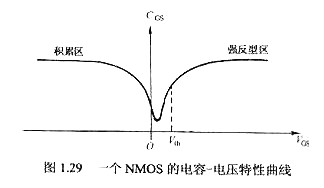
聯系方式:鄒先生
聯系電話:0755-83888366-8022
手機:18123972950
QQ:2880195519
聯系地址:深圳市福田區車公廟天安數碼城天吉大廈CD座5C1
請搜微信公眾號:“KIA半導體”或掃一掃下圖“關注”官方微信公眾號
請“關注”官方微信公眾號:提供 MOS管 技術幫助

