集成電路封裝介紹
集成電路封裝在電子學金字塔中的位置既是金字塔的尖頂又是金字塔的基座。說它同時處在這兩種位置都有很充分的根據。從電子元器件(如晶體管)的密度這個角度上來說,IC代表了電子學的尖端。但是IC又是一個起始點,是一種基本結構單元,是組成我們生活中大多數電子系統的基礎。同樣,IC不僅僅是單塊芯片或者基本電子結構,IC的種類千差萬別(模擬電路、數字電路、射頻電路、傳感器等),因而對于封裝的需求和要求也各不相同。本文對IC封裝技術做了全面的回顧,以粗線條的方式介紹了制造這些不可缺少的封裝結構時用到的各種材料和工藝。
在集成電路設計與制造過程中,封裝是不可或缺的重要一環,也是半導體集成電路的最后階段。通過把器件的核心晶粒封裝在一個支撐物之內,不僅可以有效防止物理損壞及化學腐蝕,而且還提供對外連接的引腳,使芯片能更加方便的安裝在電路板上。究竟集成電路封裝形式有哪幾種?
集成電路封裝類型
集成電路封裝類型,封裝就是指把硅片上的電路引腳用導線引到外部引腳處,以便與其他元器件連接。封裝形式是指安裝半導體集成電路芯片用的外殼形式。集成電路常見的封裝形式請見下文:
1、BGA 封裝 (ball grid array)
球形觸點陳列,表面貼裝型封裝之一。在印刷基板的背面按陳列方式制作出球形凸點用 以代替引腳,在印刷基板的正面裝配LSI 芯片,然后用模壓樹脂或灌封方法進行密封。也 稱為凸點陳列載體(PAC)。引腳可超過200,是多引腳LSI 用的一種封裝。封裝本體也可做得比QFP(四側引腳扁平封裝)小。例如,引腳中心距為1.5mm 的360 引腳 BGA 僅為31mm 見方;而引腳中心距為0.5mm 的304 引腳QFP 為40mm 見方。而且BGA 不 用擔心QFP 那樣的引腳變形問題。 該封裝是美國Motorola 公司開發的,首先在便攜式電話等設備中被采用,今后在美國有 可能在個人計算機中普及。最初,BGA 的引腳(凸點)中心距為1.5mm,引腳數為225。現在 也有一些LSI 廠家正在開發500 引腳的BGA。 BGA 的問題是回流焊后的外觀檢查。現在尚不清楚是否有效的外觀檢查方法。有的認為 ,由于焊接的中心距較大,連接可以看作是穩定的,只能通過功能檢查來處理。 美國Motorola 公司把用模壓樹脂密封的封裝稱為OMPAC,而把灌封方法密封的封裝稱為 GPAC(見OMPAC 和GPAC)。
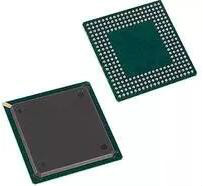
2、BQFP 封裝 (quad flat package with bumper)
帶緩沖墊的四側引腳扁平封裝。QFP 封裝之一,在封裝本體的四個角設置突起(緩沖墊) 以 防止在運送過程中引腳發生彎曲變形。美國半導體廠家主要在微處理器和ASIC 等電路中采用 此封裝。引腳中心距0.635mm,引腳數從84 到196 左右(見QFP)。

3、碰焊PGA 封裝 (butt joint pin grid array)
表面貼裝型PGA 的別稱(見表面貼裝型PGA)。
4、C-(ceramic) 封裝
表示陶瓷封裝的記號。例如,CDIP 表示的是陶瓷DIP。是在實際中經常使用的記號。
5、Cerdip 封裝
用玻璃密封的陶瓷雙列直插式封裝,用于ECL RAM,DSP(數字信號處理器)等電路。帶有玻璃窗口的Cerdip 用于紫外線擦除型EPROM 以及內部帶有EPROM 的微機電路等。引腳中 心距2.54mm,引腳數從8 到42。在日本,此封裝表示為DIP-G(G 即玻璃密封的意思)。
6、Cerquad 封裝
表面貼裝型封裝之一,即用下密封的陶瓷QFP,用于封裝DSP 等的邏輯LSI 電路。帶有窗口的Cerquad 用于封裝EPROM 電路。散熱性比塑料QFP 好,在自然空冷條件下可容許1. 5~ 2W 的功率。但封裝成本比塑料QFP 高3~5 倍。引腳中心距有1.27mm、0.8mm、0.65mm、 0.5mm、 0.4mm 等多種規格。引腳數從32 到368。
帶引腳的陶瓷芯片載體,表面貼裝型封裝之一,引腳從封裝的四個側面引出,呈丁字形 。帶有窗口的用于封裝紫外線擦除型EPROM 以及帶有EPROM 的微機電路等。此封裝也稱為 QFJ、QFJ-G(見QFJ)。

7、CLCC 封裝 (ceramic leaded chip carrier)
帶引腳的陶瓷芯片載體,表面貼裝型封裝之一,引腳從封裝的四個側面引出,呈丁字形。帶有窗口的用于封裝紫外線擦除型EPROM 以及帶有EPROM 的微機電路等。此封裝也稱為QFJ、QFJ-G(見QFJ)。

8、COB 封裝 (chip on board)
板上芯片封裝,是裸芯片貼裝技術之一,半導體芯片交接貼裝在印刷線路板上,芯片與基板的電氣連接用引線縫合方法實現,芯片與基板的電氣連接用引線縫合方法實現,并用樹脂覆蓋以確保可*性。雖然COB 是最簡單的裸芯片貼裝技術,但它的封裝密度遠不如TAB 和倒片焊技術。
9、DFP(dual flat package)
雙側引腳扁平封裝。是SOP 的別稱(見SOP)。以前曾有此稱法,現在已基本上不用。
10、DIC(dual in-line ceramic package)
陶瓷DIP(含玻璃密封)的別稱(見DIP).
11、DIL(dual in-line)
DIP 的別稱(見DIP)。歐洲半導體廠家多用此名稱。

12、DIP雙列直插式封裝
所謂DIP雙列直插式封裝,是指采用雙列直插形式封裝的集成電路芯片,絕大多數中小規模集成電路IC均采用這種封裝形式,其引腳數一般不超過100個。采用DIP封裝的CPU芯片有兩排引腳,需要插入到具有DIP結構的芯片插座上。DIP封裝的芯片在從芯片插座上插拔時應特別小心,以免損壞引腳。
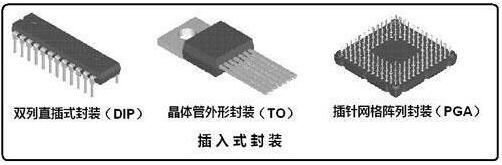
13、DSO(dual small out-lint)
雙側引腳小外形封裝。SOP 的別稱(見SOP)。部分半導體廠家采用此名稱。

14、DICP(dual tape carrier package)
雙側引腳帶載封裝。TCP(帶載封裝)之一。引腳制作在絕緣帶上并從封裝兩側引出。由于利用的是TAB(自動帶載焊接)技術,封裝外形非常薄。常用于液晶顯示驅動LSI,但多數為定制品。另外,0.5mm 厚的存儲器LSI 簿形封裝正處于開發階段。在日本,按照EIAJ(日本電子機械工業)會標準規定,將DICP 命名為DTP。
15、DIP(dual tape carrier package)
同上。日本電子機械工業會標準對DTCP 的命名(見DTCP)。
16、FP(flat package)
扁平封裝。表面貼裝型封裝之一。QFP 或SOP(見QFP 和SOP)的別稱。部分半導體廠家采用此名稱。
17、Flip-chip
倒焊芯片。裸芯片封裝技術之一,在LSI 芯片的電極區制作好金屬凸點,然后把金屬凸點與印刷基板上的電極區進行壓焊連接。封裝的占有面積基本上與芯片尺寸相同。是所有封裝技術中體積最小、最薄的一種。但如果基板的熱膨脹系數與LSI 芯片不同,就會在接合處產生反應,從而影響連接的可靠性。因此必須用樹脂來加固LSI 芯片,并使用熱膨脹系數基本相同的基板材料。
其中SiS 756北橋芯片采用最新的Flip-chip封裝,全面支持AMD Athlon 64/FX中央處理器。支持PCI Express X16接口,提供顯卡最高8GB/s雙向傳輸帶寬。支持最高HyperTransport Technology,最高2000MT/s MHz的傳輸帶寬。內建矽統科技獨家Advanced HyperStreaming TechnologyMuTIOL1GTechnology。
18、FQFP(fine pitch quad flat package)
小引腳中心距QFP。通常指引腳中心距小于0.65mm 的QFP(見QFP)。部分導導體廠家采用此名稱。塑料四邊引出扁平封裝PQFP(Plastic Quad Flat Package)
PQFP的封裝形式最為普遍。其芯片引腳之間距離很小,引腳很細,很多大規模或超大集成電路都采用這種封裝形式,引腳數量一般都在100個以上。Intel系列CPU中80286、80386和某些486主板芯片采用這種封裝形式。此種封裝形式的芯片必須采用SMT技術(表面安裝設備)將芯片與電路板焊接起來。采用SMT技術安裝的芯片不必在電路板上打孔,一般在電路板表面上有設計好的相應引腳的焊點。將芯片各腳對準相應的焊點,即可實現與主板的焊接。用這種方法焊上去的芯片,如果不用專用工具是很難拆卸下來的。SMT技術也被廣泛的使用在芯片焊接領域,此后很多高級的封裝技術都需要使用SMT焊接。
以下是一顆AMD的QFP封裝的286處理器芯片。0.5mm焊區中心距,208根I/O引腳,外形尺寸28×28mm,芯片尺寸10×10mm,則芯片面積/封裝面積=10×10/28×28=1:7.8,由此可見QFP比DIP的封裝尺寸大大減小了。


19、H-(with heat sink)
表示帶散熱器的標記。例如,HSOP 表示帶散熱器的SOP。

20、Pin Grid Array(Surface Mount Type)
表面貼裝型PGA。通常PGA 為插裝型封裝,引腳長約3.4mm。表面貼裝型PGA 在封裝的底面有陳列狀的引腳,其長度從1.5mm 到2.0mm。貼裝采用與印刷基板碰焊的方法,因而也稱為碰焊PGA。因為引腳中心距只有1.27mm,比插裝型PGA 小一半,所以封裝本體可制作得不怎么大,而引腳數比插裝型多(250~528),是大規模邏輯LSI 用的封裝。封裝的基材有多層陶瓷基板和玻璃環氧樹脂印刷基數。以多層陶瓷基材制作封裝已經實用化。
21、MFP 封裝( mini flat package)
小形扁平封裝。塑料SOP或SSOP的別稱(見SOP和SSOP)。部分半導體廠家采用的名稱。
聯系方式:鄒先生
聯系電話:0755-83888366-8022
手機:18123972950
QQ:2880195519
聯系地址:深圳市福田區車公廟天安數碼城天吉大廈CD座5C1
請搜微信公眾號:“KIA半導體”或掃一掃下圖“關注”官方微信公眾號
請“關注”官方微信公眾號:提供 MOS管 技術幫助

